High Vacuum Multi-Target Magnetron Sputtering System – Precision Thin Film Deposition for Nanotechnology & Industrial
Model: Lith-TK-JS02-Precision Thin Film Deposition for Nanotechnology
I. System Overview
Features & Applications
The Lith-TK-JS02 is a high-vacuum multi-target magnetron sputtering coating system, integrating advanced components such as:
· Sputtering chamber
· Magnetron sputtering targets
· DC/pulse sputtering power supply
· Auto-matching RF power supply
· Pulse bias power supply
· Sample heating system
· Vacuum & gas delivery systems
· PLC + touchscreen semi-automatic control system
With a compact, host-control integrated design, the system offers user-friendly operation and space efficiency. It is widely adopted in:
· Universities & research institutes for academic and R&D experiments.
· Industrial enterprises for exploratory trials and new product development.
Key Applications:
1. Nanoscale single-layer, multilayer, and composite films.
2. Deposition of diverse films:
o Metallic/Alloy (Ag, Al, Cu, NiCr, etc.)
o Semiconductor/Ceramic/Dielectric (TiO₂, TiN, CrN, ITO, SiO₂, etc.).
3. Flexible deposition modes: Single-target, sequential, or co-sputtering with three targets.
II. Technical Specifications
Parameter
Specification
Vacuum Chamber
Ø500×H420 mm, 304 stainless steel, front-opening design.
Vacuum System
Hybrid molecular pump + rotary vane pump + high-vacuum valve; digital vacuum gauge.
Ultimate Vacuum
≤6.0×10⁻⁵ Pa (after 24-hour pumping, no load).
Leak Rate
≤0.8 Pa/h (pressure rise rate); ≤10 Pa after 12 hours without pumping.
Pumping Speed
≤15 min (ambient to 5.0×10⁻³ Pa, no load).
Substrate Stage
Ø150 mm, compatible with various substrate sizes.
Rotation & Heating
0–20 rpm rotation; heating range: RT–500±1°C (Shimaden PID closed-loop control).
Sputtering Targets
3× 3-inch permanent magnet co-focal targets (adjustable angle/height); RF/MF/DC compatible (supports magnetic materials); pneumatic shutter.
Deposition Modes
Independent/sequential/co-sputtering (bottom-up configuration).
Pulse Bias Power
-1000 V, 1 set.
Film Uniformity
≤±5% (within Ø100 mm area).
Control System
PLC + touchscreen HMI (semi-automatic).
Safety Protections
Alarms and safeguards for water shortage, overcurrent/voltage, circuit faults; logic interlock system.
Dimensions (Main Unit)
1900(L)×800(W)×1900(H) mm.
III. Competitive Advantages
1. Versatility – Supports diverse materials (metals, ceramics, semiconductors) and complex film structures.
2. Precision Control – PID temperature regulation (±1°C) and high film uniformity (±5%).
3. User-Oriented Design – Compact footprint, intuitive interface, and robust safety features.
4. Research-Grade Performance – High vacuum (10⁻⁵ Pa) and flexible sputtering modes ideal for R&D and pilot production.
I. System Overview
Features & Applications
The Lith-TK-JS02 is a high-vacuum multi-target magnetron sputtering coating system, integrating advanced components such as:
· Sputtering chamber
· Magnetron sputtering targets
· DC/pulse sputtering power supply
· Auto-matching RF power supply
· Pulse bias power supply
· Sample heating system
· Vacuum & gas delivery systems
· PLC + touchscreen semi-automatic control system
With a compact, host-control integrated design, the system offers user-friendly operation and space efficiency. It is widely adopted in:
· Universities & research institutes for academic and R&D experiments.
· Industrial enterprises for exploratory trials and new product development.
Key Applications:
1. Nanoscale single-layer, multilayer, and composite films.
2. Deposition of diverse films:
o Metallic/Alloy (Ag, Al, Cu, NiCr, etc.)
o Semiconductor/Ceramic/Dielectric (TiO₂, TiN, CrN, ITO, SiO₂, etc.).
3. Flexible deposition modes: Single-target, sequential, or co-sputtering with three targets.
II. Technical Specifications
Parameter
Specification
Vacuum Chamber
Ø500×H420 mm, 304 stainless steel, front-opening design.
Vacuum System
Hybrid molecular pump + rotary vane pump + high-vacuum valve; digital vacuum gauge.
Ultimate Vacuum
≤6.0×10⁻⁵ Pa (after 24-hour pumping, no load).
Leak Rate
≤0.8 Pa/h (pressure rise rate); ≤10 Pa after 12 hours without pumping.
Pumping Speed
≤15 min (ambient to 5.0×10⁻³ Pa, no load).
Substrate Stage
Ø150 mm, compatible with various substrate sizes.
Rotation & Heating
0–20 rpm rotation; heating range: RT–500±1°C (Shimaden PID closed-loop control).
Sputtering Targets
3× 3-inch permanent magnet co-focal targets (adjustable angle/height); RF/MF/DC compatible (supports magnetic materials); pneumatic shutter.
Deposition Modes
Independent/sequential/co-sputtering (bottom-up configuration).
Pulse Bias Power
-1000 V, 1 set.
Film Uniformity
≤±5% (within Ø100 mm area).
Control System
PLC + touchscreen HMI (semi-automatic).
Safety Protections
Alarms and safeguards for water shortage, overcurrent/voltage, circuit faults; logic interlock system.
Dimensions (Main Unit)
1900(L)×800(W)×1900(H) mm.
III. Competitive Advantages
1. Versatility – Supports diverse materials (metals, ceramics, semiconductors) and complex film structures.
2. Precision Control – PID temperature regulation (±1°C) and high film uniformity (±5%).
3. User-Oriented Design – Compact footprint, intuitive interface, and robust safety features.
4. Research-Grade Performance – High vacuum (10⁻⁵ Pa) and flexible sputtering modes ideal for R&D and pilot production.
The Lith-TK-JS02 is a high-vacuum multi-target magnetron sputtering coating system, integrating advanced components such as:
|
Parameter |
Specification |
|
Vacuum Chamber |
Ø500×H420 mm, 304 stainless steel, front-opening design. |
|
Vacuum System |
Hybrid molecular pump + rotary vane pump + high-vacuum valve; digital vacuum gauge. |
|
Ultimate Vacuum |
≤6.0×10⁻⁵ Pa (after 24-hour pumping, no load). |
|
Leak Rate |
≤0.8 Pa/h (pressure rise rate); ≤10 Pa after 12 hours without pumping. |
|
Pumping Speed |
≤15 min (ambient to 5.0×10⁻³ Pa, no load). |
|
Substrate Stage |
Ø150 mm, compatible with various substrate sizes. |
|
Rotation & Heating |
0–20 rpm rotation; heating range: RT–500±1°C (Shimaden PID closed-loop control). |
|
Sputtering Targets |
3× 3-inch permanent magnet co-focal targets (adjustable angle/height); RF/MF/DC compatible (supports magnetic materials); pneumatic shutter. |
|
Deposition Modes |
Independent/sequential/co-sputtering (bottom-up configuration). |
|
Pulse Bias Power |
-1000 V, 1 set. |
|
Film Uniformity |
≤±5% (within Ø100 mm area). |
|
Control System |
PLC + touchscreen HMI (semi-automatic). |
|
Safety Protections |
Alarms and safeguards for water shortage, overcurrent/voltage, circuit faults; logic interlock system. |
|
Dimensions (Main Unit) |
1900(L)×800(W)×1900(H) mm. |
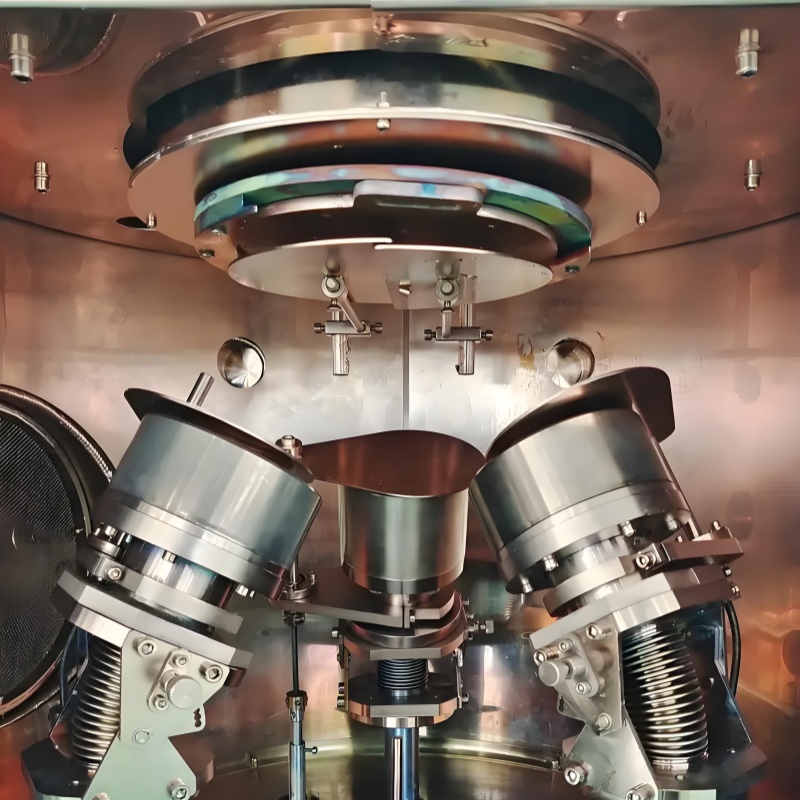










 Tel : +86-592-3926659
Tel : +86-592-3926659 Email : gilia@inthelaboratory.com
Email : gilia@inthelaboratory.com

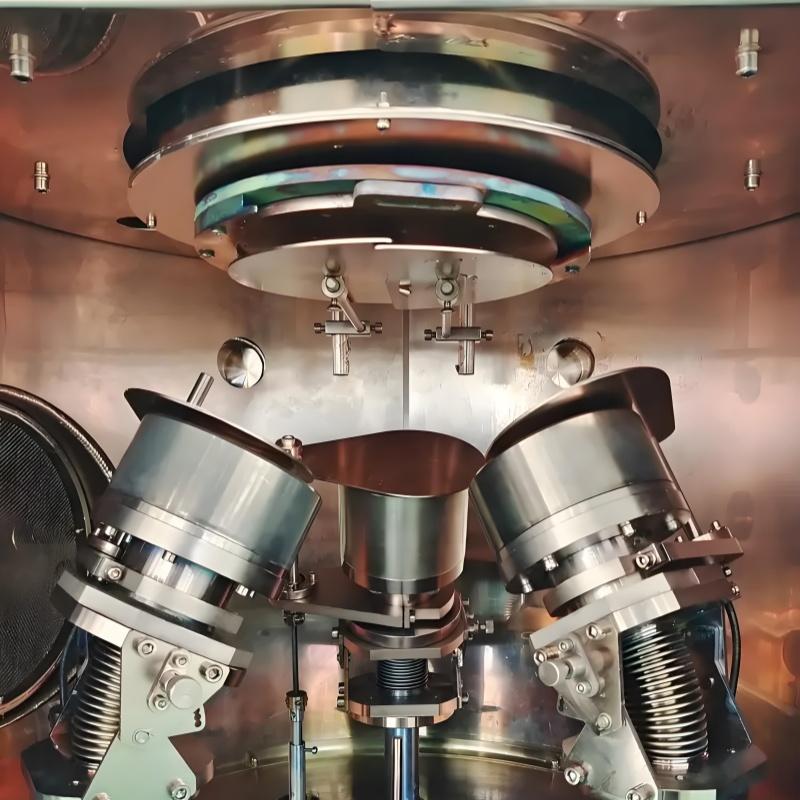











 IPv6 network supported
IPv6 network supported 